





BGA(球柵陣列封裝)是一種典型的高密度封裝技術,其特點是芯片引腳以球形焊點按陣列形式分布在封裝下面,可使器件更小、引腳數更多、引腳間距更大、成品組裝率更高和電性能更優良。因此這種封裝類型器件應用越來越廣泛。但是由于BGA焊點隱藏在芯片底部,焊接裝配后不利于檢測,另一方面國家或行業沒有制定BGA焊接質量檢測驗收標準,所以BGA焊接質量的檢測技術是這類器件應用中的一大問題。
目前BGA焊接質量檢測手段非常局限,常用的檢測手段包括:目檢、飛針電子測試、X射線檢測、染色檢測和切片檢測。其中染色和切片檢測為破壞性檢測,可作為失效分析手段,不適于焊接質量檢測。無損檢測中目檢僅能檢測器件邊緣的焊球,不能檢測焊球內部缺陷;飛針電子測試誤判率太高;而X射線檢測利用X射線透射特性,可以很好地檢測隱藏在器件下方的焊球焊接情況,是目前最有效的BGA焊接質量檢測方法。但是目前X射線僅限于檢測連焊和空洞等有限的幾種缺陷的檢測,不能覆蓋全部BGA焊接缺陷;同時缺乏檢測標準。
1 常見的BGA焊接缺陷及其特征
1.1 焊球橋連
BGA焊球橋連是指兩個或多個BGA焊球粘連在一起形成短路的一種缺陷。這種缺陷是由于BGA焊球融化后流動造成粘連導致的一種缺陷。由于這種缺陷會導致短路是決不允許的一種嚴重缺陷。
1.2 焊球丟失
BGA焊球丟失是指焊接后出現焊球缺失的一種缺陷。這種缺陷可能是由于植球過程中遺漏,也可能是焊接過程中焊球流入PCB通孔造成的一種缺陷。這種缺陷將直接導致無電氣連接,是決不允許出現的嚴重缺陷。
1.3 焊球移位
焊球移位是指BGA焊球與PCB焊盤未能完全對準,存在相對位移的一種缺陷。這種缺陷常常不影響電氣連接,但對器件焊接的機械性能有影響。實際工作中常常允許焊球相對于焊盤有最大25%的位移,但是相鄰焊球之間的間隙不能減小25%及以上。
1.4 焊球空洞
焊球空洞是指BGA焊球中存在氣泡的一種缺陷。這種缺陷往往是由于焊錫膏中的有機成分未能及時排除或焊盤未清洗干凈造成的。焊球氣泡對信號傳輸有一些影響 ,而更主要的影響是氣泡會影響機械性能。實際工作中生產單位或使用方常常規定焊點內氣泡總量不超過某一閾值,比如空洞面積小于等于焊球投影面積的25%即為合格。
1.5 虛焊
虛焊是指BGA焊球未與焊盤形成真正的電氣連接的一種缺陷。這種缺陷往往與金屬間化合物的形成有關,表現形式是電氣連接不良或不通,對其施加外力時電氣連接良好。除這些間接表現形式外,虛焊難以通過無損方式直接被檢測到。
1.6 枕頭效應(HIP)
枕頭效應是指BGA焊球和焊膏沒有完全融合在一起或成部分融合擠壓的凹形或沒有擴散的凸形 。這種缺陷常常沒有特殊的表現形式,并且不容易被檢測手段查出,但是在后期使用過程焊點容易斷裂形成虛焊,所以危害較大。
2 X射線檢測BGA焊接質量
2.1 X射線檢測設備
X射線檢測常用設備是X射線實時成像系統,該設備分為二維成像和3D斷層掃描兩類。其原理都是利用X射線穿透被測樣品后,被圖像接收器接收后轉化為圖像信號,圖像表現出明顯的灰度對比。圖像中灰度大的區域表明X光能量衰減多,說明該區域材料厚或材料原子序數大。二維成像觀察到的是被測件的俯視圖,它具有成像快的優點。圖1為正常BGA焊球二維X射線圖,圖片中黑色圓為BGA焊球。因為焊球成分為錫合金,所以吸收X光多,相對于周邊材料灰度大。三維斷層掃描是利用設備中機械裝置旋轉,從各個角度對樣品進行掃描,通過軟件分析處理,形成被測樣品三維形貌。這種測試方式能更真實和清晰地反映被測樣品內部的真實狀態,但是掃描時間長,測試成本高。
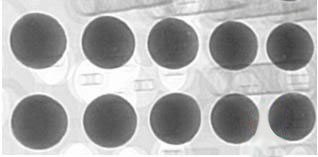
圖1 正常BG A焊球二維X射線圖
2.2 BGA焊接質量的X射線檢測流程
BGA器件常常有數百粒焊球,并且可能同時具有多種焊接缺陷。檢測既不能漏掉某類缺陷又要兼顧效率,工程經驗和合理的檢測流程十分重要。圖2為BGA焊接質量的X射線檢測流程,先通過二維X射線檢測BGA焊接,再根據檢測結果分析是否需要進行3D斷層掃描。二維X射線檢測應采用五點檢測法:著重檢測器件四周及中心五點,快速檢測其他區域。如果BGA焊球形狀(正常為圓形)、大小和灰度都無異常,那么可不進行3D斷層掃描檢測;若存在焊球大小異常、形狀異常、空洞較大和邊界模糊等,則需要對這些焊球進行3D掃描。

圖2 BG A焊接質量的X射線檢測流程
3 實驗驗證及檢測判據
3.1 焊球橋連與焊球丟失檢測
二維X射線檢測很容易檢測到這兩種缺陷。常常僅需觀察BGA器件的全貌就能輕易發現是否存在焊球橋連和焊球丟失。焊球橋連在X射線圖片中的表現是相鄰的焊球之間沒有間隙。圖3為BGA焊球橋連X射線形貌,圖中紅色圓內即是相鄰兩個焊球橋連的情況。因為BGA焊球是以相同間距整齊排列在器件下方,所以焊球丟失在X射線檢測圖片中的表現更加明顯。常見的形貌是在相應位置缺少焊球,圖4為BGA焊球丟失X射線形貌,箭頭所指區域丟失了一顆焊球。
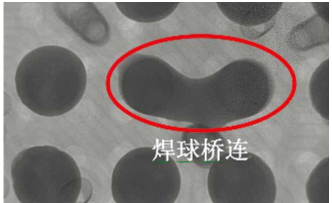
圖3 BG A焊球橋連的X射線形貌
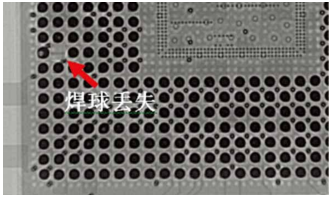
圖4 BG A焊球丟失的X射線形貌
3.2 焊球移位檢測
焊球移位的表現形式是BGA焊球整體向某一方向扭曲。這種缺陷很容易被X射線檢測所觀察,更關鍵的是需要檢測焊球移位的嚴重程度。這需要將BGA放大,并調節X射線強度和圖像對比度等參數,使圖像足夠清晰,以便測量焊球中心相對于焊盤偏移的程度。圖5為焊球移位二維俯視圖, L 為焊球球心至焊盤圓心的距離, D 為焊盤直徑。焊球移位偏移量的計算公式為 L / D 。這個偏移量一般需要根據用戶的具體需求來判定焊接是否合格,通用的判據為L / D <25%。
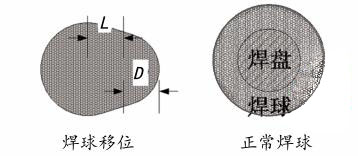
圖5 位焊球俯視圖
3.3 焊球空洞檢測
通過二維X射線成像很容易觀察到焊球內部空洞,圖6為焊球空洞的X射線形貌。圖中箭頭所指的區域即是焊球空洞,焊點黑色背景中的白色明亮部分。X射線成像系統在軟件中都集成了焊球空洞面積計算功能。一般來說若空洞面積總和超過焊球面積的25%為不合格,需要返修。
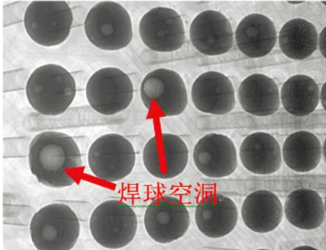
圖6 球空洞的X射線形貌
3.4 虛焊檢測
3.4.1 二維X射線檢測初步診斷虛焊
為提升檢測效率,常常先用二維X射線對有無虛焊做初步診斷。具體操作時將X光光源傾斜進行觀察。圖7為傾斜光源后焊球X射線二維形貌,如圖7所示應能看到相互嵌套的三個圓。若僅能看到其中兩個圓,同時焊球形狀異常(周界模糊,大小異常,灰度較暗),那么這類焊球很有可能有虛焊的缺陷,應進行3D斷層掃描檢測。
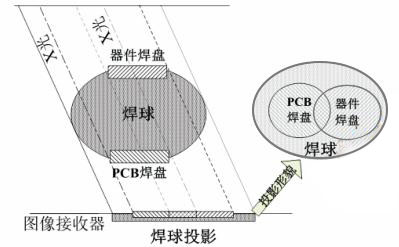
圖7 傾斜光源后焊球X射線二維形貌
3.4.2 3D X射線檢測檢測虛焊
虛焊很難通過二維X射線檢測觀測,更多的時候這種缺陷僅能通過切片做金像觀察來檢測,而這種方式是破壞性的。隨著技術進步可以通過借助3D斷層掃描來完成檢測。圖8為BGA虛焊的 3D形貌及截面斷層掃描圖,畫面左側金色球體為BGA焊球3D形貌圖,紅色圓圈中的焊球為虛焊焊球;畫面右側為焊球的斷層掃描截面圖,紅色圓圈中為虛焊焊球。

圖8 BGA虛焊的3D形貌及截面圖
3.5 枕頭效應檢測
與虛焊類似,枕頭效應也很難通過二維X射線檢測來觀測,而是需要借助3D斷層掃描來檢測。圖9為BGA焊球枕頭效應X射線3D形貌,圖10則是BGA焊球枕頭效應截面斷層掃描形貌。
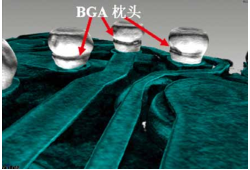
圖9 BGA焊球枕頭效應X射線3D形貌
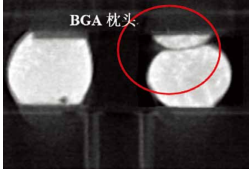
圖10 BGA焊球枕頭效應截面斷層掃描形貌
BGA焊接質量包括焊球連焊、焊球丟失、焊球移位、焊球空洞、虛焊和枕頭效應。這些缺陷都會影響電路的可靠性,有些是立即表現出來,如焊球連焊會形成短路;而有些則在使用中表現出來,比如枕頭效應在使用中焊球易在枕頭處斷裂形成虛焊。即時表現的缺陷我們通過一些檢測比較容易排查,而非即時表現的缺陷對電子系統危害更大,則更應該加強檢測及時排查。
一般認為X射線僅能檢測包括連焊、焊球丟失、焊球移位和空洞這幾類缺陷。引入3D斷層掃描,使得X射線檢測能覆蓋所有BGA焊接常見缺陷。特別是虛焊和枕頭效應的檢測,不再僅僅依賴破壞性檢測手段。另一方面,在實際工程應用中,為兼顧檢測效率,需要將二維成像和3D斷層掃描結合。通過二維成像快速檢測整體焊接質量,排查焊球連焊、焊球丟失、焊球移位和焊球空洞,初步判定虛焊。再根據實際情況用3D斷層掃描確診是否存在虛焊和枕頭效應。綜合利用兩種技術手段可以完成BGA器件焊接質量檢測,為BGA器件應用提供可靠的質量保證。
想了解更多日聯科技X-ray檢測裝備信息可以撥打全國服務熱線:400-880-1456 或訪問日聯科技官網:www.healthybodylife.com