




倒裝芯片的英文名稱稱為Flip Chip,它用于將芯片的觸點與基板,載體和電路板連接起來。在連接過程中,由于芯片的凸塊向下連接,因此稱為倒裝芯片。
在典型的倒裝芯片封裝中,芯片通過3-5厚的焊料凸點連接到芯片載體。底部填充材料用于保護焊料凸點。芯片Chip和PCB板通過倒裝技術連接在一起。
在日常生活中,許多電子組件都使用倒裝芯片焊接技術,例如計算機中的存儲棒,這很常見。如果從橫截面切開內存條,則芯片和電路板通過倒裝芯片技術連接。
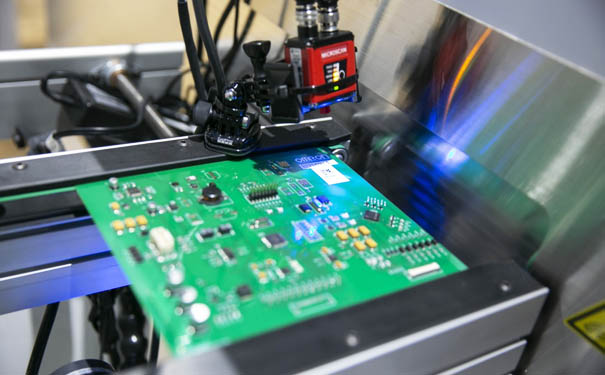
倒裝芯片主要通過四個步驟完成:
步驟1:凸點底部金屬化(UBM)
凸塊金屬化是為了激發半導體中PN結的性能。其中,最適合熱壓倒裝芯片連接的凸點材料是金。可以通過傳統的電解金電鍍方法或柱形凸塊方法來產生凸塊。后者是引線鍵合技術中常用的凸點形成工藝。
凸點底部金屬化(UBM)的沉積方法主要包括:
濺射:使用濺射在硅晶片上逐層沉積薄膜,然后通過光刻形成UBM圖案,然后蝕刻非圖案的部分。
蒸鍍:使用掩模,通過蒸發在硅晶片上逐層沉積。該選擇性沉積掩模可用于形成相應的凸塊。
化學鍍:化學鍍用于選擇性地將Ni鍍在Al焊盤上。鋅酸鹽工藝通常用于處理Al表面。無需真空和圖案蝕刻設備,成本低廉。
步驟2:芯片凸點
該部分將形成凸點,可以將其視為P-N結的電極,類似于處理電池的輸出端子。
形成凸點的常見方法:蒸發的焊料塊、電鍍錫球、印刷凸點、釘頭焊錫凸塊、放球凸點、焊錫轉移凸點
觀察典型的電鍍焊料凸點:在掃描電子顯微鏡下觀察完成的凸點微觀形狀是均勻的金屬球。
步驟3:將凸起的芯片組裝到基板/板上
在熱壓連接過程中,芯片的凸塊通過加熱和加壓而連接到基板的焊盤。
此過程要求芯片或基板上的凸塊是金凸塊,并且同時必須有一個可以連接到凸塊的表面,例如金或鋁。對于金塊,連接溫度通常約為300°C,以便在連接過程中充分軟化材料并促進擴散。
步驟4:使用非導電材料填充芯片底部的孔
填充時,將倒裝芯片和基板加熱到70至75°C,并使用裝有填充劑的L形注射器沿芯片邊緣沿兩個方向注入填充劑。
由于間隙中毛細管的虹吸作用,填料被吸入并流向中心。
芯片邊緣有阻擋層,可防止泄漏。一些使用傾斜襯底以促進流動的方法。填充完成后,在烤箱中分批升高溫度,以達到約130℃的固化溫度,并可以通過保持3到4小時來實現固化。
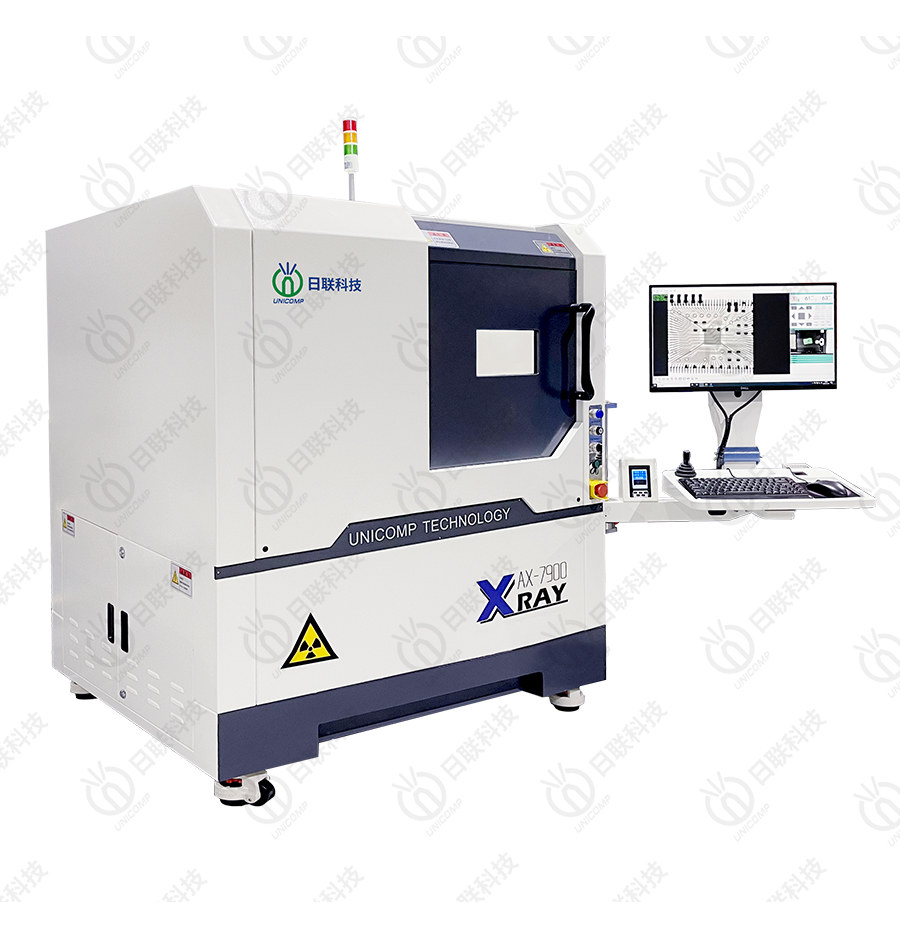
經過上述四個步驟,完成了芯片與基板之間的倒裝芯片連接。盡管介紹起來并不復雜,但是完成這些步驟仍然是一個系統的項目,出了倒裝過程,還包含各環節的質量檢測,xray技術是目前在芯片制造環節使用較為廣泛的檢測方案,日聯科技作為業內首屈一指的國內X射線檢測方案的提供商,廣受業界好評。
了解更多日聯科技X-ray檢測裝備信息可以撥打全國服務熱線:400-880-1456 或訪問日聯科技官網:www.healthybodylife.com
