




BGA是一種典型的高密度封裝技術。其特點是芯片引腳以球形焊點的形式分布在封裝下方,這可以使器件更小,引腳更多,引腳間距更大,成品組裝率更高,電氣性能更好。因此,這種封裝式裝置的應用越來越廣泛。但是,由于BGA焊點隱藏在芯片的底部,因此不利于焊接和組裝后的檢查。另一方面,國家或行業還沒有制定BGA焊接質量檢驗和驗收標準,因此BGA焊接質量檢驗技術是此類設備應用中的主要問題。
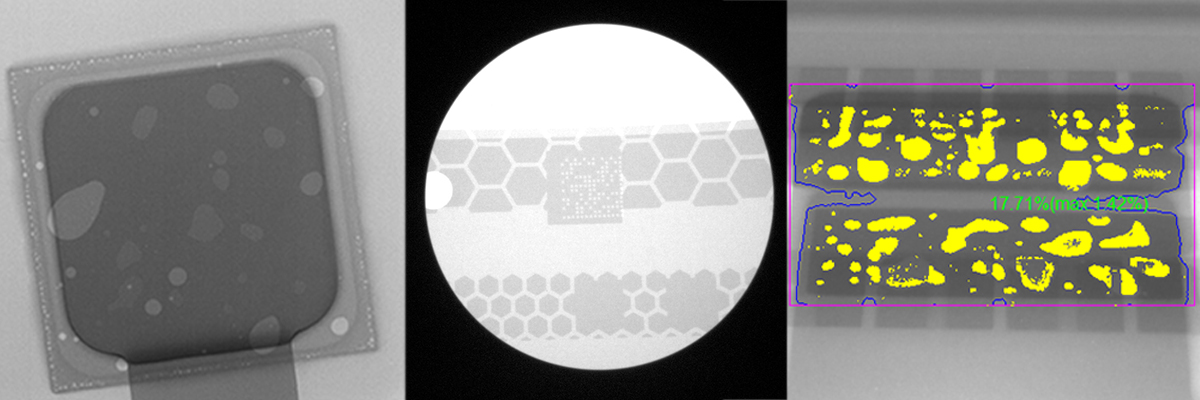
目前,BGA焊接質量檢查方法非常有限。常見的檢查方法包括:外觀檢查,飛針電子測試,X射線檢查,染色檢查和切片檢查。其中,染色和斷面檢查是破壞性檢查,可以用作故障分析方法,不適合焊接質量檢查。在無損檢測中,目視檢查只能檢測到設備邊緣的焊錫球,而不能檢測焊錫球的內部缺陷。飛針電子測試的誤報率過高; X射線檢查利用X射線透射特性,可以很好地檢測設備下的隱藏物。焊球的焊接條件是有效的BGA焊接質量檢查方法。但是,X射線目前僅限于檢測有限數量的缺陷,例如連續焊接和空洞,并且無法覆蓋所有BGA焊接缺陷。同時,缺乏檢驗標準。
目前,該國尚未制定BGA焊接質量或驗收標準,也沒有相關的國家軍事標準或行業標準。國際電子工業連接協會已制定了相關標準,包括“ IPC-A-610電子元件的可接受性”,“ IPC-J-STD-001焊接電子電氣元件的要求”和“ IPC-7095 BGA設計和組裝過程的實現”。其中,IPC-A-610規定了BGA焊接的可接受性:**的BGA焊點通過X射線檢查,表現為焊點光滑,邊界清晰,無空隙。所有焊點的直徑,體積,灰度和對比度均一致,并且位置準確無偏移或扭曲。可接受性條款只是一個相對定性的條款,不能滿足實際的測試要求。
X射線檢查常用的設備是X射線實時成像系統,分為兩種類型:二維成像和3D層析成像。其原理是利用X射線穿透待測樣品,然后由圖像接收器接收后將其轉換為圖像信號,圖像顯示出明顯的灰度對比度。圖像中具有較大灰度的區域表示X射線能量衰減大,表明該區域中的材料較厚或該材料的原子序數較大。二維成像觀察被測零件的頂視圖,這具有快速成像的優勢。普通BGA焊球的二維X射線圖像。圖中的黑色圓圈是BGA焊球。由于焊球是由錫合金制成的,因此它吸收更多的X射線,并且相對于周圍的材料具有更大的灰度級。三維斷層掃描利用設備中機械設備的旋轉來從各個角度掃描樣品,并對軟件進行分析和處理以形成被測樣品的三維形狀。該測試方法可以更真實,更清晰地反映被測樣品的真實狀態。
BGA焊接的質量包括連續焊接,缺少焊球,移動的焊球,焊球空隙,虛擬焊接和枕形效應。這些缺陷將影響電路的可靠性。它們中的一些立即顯現出來,例如連接焊球時發生短路。一些在使用中表現出來,例如枕頭效應。在使用中,焊球很容易在枕頭上折斷并形成假焊料。通過一些測試,我們可以輕松地對實時性能的缺陷進行故障排除,而非實時性能的缺陷對電子系統的危害更大,因此,我們應該加強檢測和及時調查。
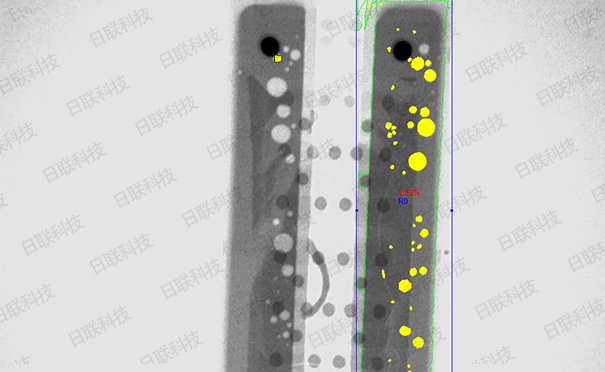
通常認為X射線只能檢測包括連續焊接,焊球損失,焊球位移和空隙在內的缺陷。3D層析成像技術的引入使X射線檢查能夠覆蓋BGA焊接中的所有常見缺陷。特別是,錯誤焊接和枕形效應的檢測不再僅取決于破壞性的檢測方法。另一方面,在實際工程應用中,為了考慮檢測效率,有必要將二維成像和3D層析成像相結合。通過二維成像快速檢測整體焊接質量,檢查焊球的連續焊接,焊球損失,焊球位移和焊球空隙,并初步確定虛假焊錫。根據實際情況,使用3D斷層掃描來確認是否存在虛假的焊接和枕形效應。兩種技術手段的綜合運用可以完成BGA器件的焊接質量檢驗,并為BGA器件的應用提供可靠的質量保證。
了解更多日聯科技X-ray檢測裝備信息可以撥打全國服務熱線:400-880-1456 或訪問日聯科技官網:www.healthybodylife.com
