




隨著組件包裝的飛速發展,電子組裝正朝著緊湊,小型化,輕薄化的方向發展。 BGA,Flip,Chip和CSP等高科技封裝技術的出現,使表面貼裝電子組件變得越來越復雜。當然,具有挑戰性的是,這增加了焊點測試的難度。
X射線焊點檢查著重于焊點的物理結構測試,克服了其他測試方法的缺陷,可以實現令人滿意的缺陷覆蓋率,尤其是對于隱藏式焊點測試。

在當前的實際應用中,我們使用的表面貼裝封裝只不過是以下幾種:芯片組件,翼形引線組件,J形引線組件,柵格陣列等。由于各種焊料的物理結構不同焊點,X射線下各種焊點的圖像也不同。從這些圖像中,我們可以判斷焊點的焊接質量并提供過程反饋,從而實現過程的過程。控制。
常見的焊接缺陷主要包括以下幾種:橋接,開路焊接,錫不足,錫過多,對準不良,空洞,焊珠,缺少的組件或銷釘等。以下我將列出焊點的可能類型X射線焊點圖像,并對缺陷焊點的圖像進行一些粗略的分析。
1.芯片元件的焊點主要的常見芯片元件是:片狀電阻器和片狀電容器。這些組件只有兩個焊錫末端,并且焊點結構相對簡單。由于各種芯片組件的主體材料不同,因此可以在X射線下完全穿透芯片電阻器。只有兩端的鉛錫焊點才能阻擋X射線; X射線無法穿透材料,但是不可能在鉭電容器的陰極附近穿上特殊物質,因此可以判斷鉭電容器的極性是否正確以及是否缺少組件。
芯片組件的常見缺陷主要包括開放式焊接,焊珠等。其他缺陷相對較少。通常,只要可以合理控制這些常見缺陷,它們就很大程度上與焊接溫度曲線和焊盤設計等因素有關,基本上可以避免。
2.翼形引線組件主要有兩種類型:QFP和SOIC。除引線間距外,這兩種類型的焊點圖像均相同。通常合格的焊點在腳跟部分應有足夠的焊料高度。引線底部的鍵合表面中間應有良好的焊料填充。至于引線末端的焊料,通常認為可以忽略不計,因為它對焊點的強度沒有重大影響。根據焊料的三個部分和焊點的長度,再評估焊點的質量。
3. J引線組件主要有兩種類型:PLCC和SOJ。兩者的焊接接頭圖像相同,并且QFP和SOIC的焊接接頭力相似。區別在于:由于J引線組件的結構特性,焊點在腳跟和引腳末端之間的焊錫量差異很小,因此每個焊點圖像的兩端都是尺寸相似,灰度等級相似,并且焊點中間的灰度等級最小。
J引線組件的常見缺陷。幾個焊點的X射線圖像。對于要求不高的電子產品,也可以忽略PLCC和SOJ的其他缺陷,例如“錫缺乏”和“錫過量”。遵循的原則與QFP和SOIC相同。 “對齊不良”缺陷。對于J引線組件,很少有單引腳偏離的情況。 “引線或組件缺失”缺陷實際上是“開放式焊接”的特殊情況。它的X射線圖像與QFP&SOIC的“焊接”圖像非常相似。因此,很少發生J引線組件的“空洞”缺陷。
第四,BGA焊點BGA隱藏的焊點只能通過X射線檢測,沒有更好的檢測方法。在實際測試過程中,正是正是由于特征尺寸和圓圈灰度的變化,才可以評估BGA焊點的質量。
BGA“橋接”通常不容易發生,但在某些情況下,例如在印刷漿料時橋接,由貼片的BGA的大位移引起的錫膏橋接,以及因不正確的固化引起的錫膏中的氣泡飛濺。焊接溫度曲線形成“橋接”缺陷,在X射線下很容易識別。目前,普通的X射線設備可以檢測到BGA的“橋接”。
BGA“焊球缺失”缺陷的主要原因是,在移動貼片之前未完成檢查。可以完全避免這種缺陷。 X射線下不良焊點的圖像非常直觀。 BGA“空隙”的形成與焊接溫度曲線有關。不合適的溫度曲線會在回流期間在焊錫袋內部形成氣泡。該氣泡的進一步膨脹還可能在相鄰的焊點之間形成“橋梁”。或使“焊料珠”形成。在BGA中形成“焊珠”的原因很多,通常是由焊膏特性曲線和焊接溫度曲線的不匹配引起的,因此X射線下“焊珠”的焊點圖像非常簡單。
上面列出了X射線圖像下四種類型的焊點:從測試的角度來看,X射線焊點檢查是一種全新的測試概念。與傳統的測試方法相比,它是一種更先進的測試方法,它消除了以往測試方法對測試方法的種種限制,并可以獲得令人滿意的缺陷覆蓋率,因此X射線的應用前景仍然相當樂觀。
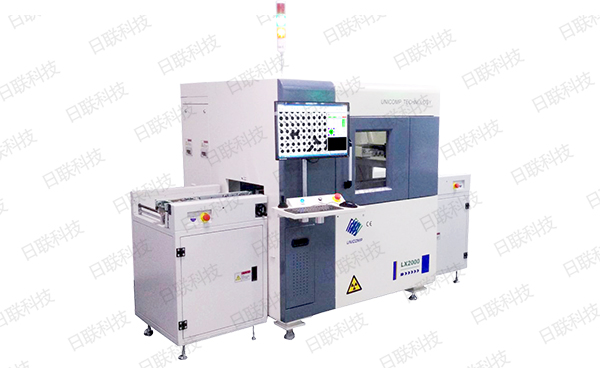
想了解更多日聯科技X-ray檢測裝備信息可以撥打全國服務熱線:400-880-1456 或訪問日聯科技官網:www.healthybodylife.com